�����Y��
�c���y�Ļ����{��ʯ��Ƭ�ĵ����������ȣ��������������@����������������ɱ����@�錍�F����批��ʰ댧�w�����Ĵ�Ҏģ���õ��ƽ�˵�·���D 1�@ʾ�� GaN ���w�ܵĵ��������Y������ AlGaN �Ӻ� GaN �ӵ�߅���γ��˾��и��w���ʵĶ��S��Ӛ� ��2DEG���ߌ��ͨ��������������ٔ��d���ӣ���ɢ�ر����`�ڹ辧���У������Ĺ辧�w�ܣ�GaN ���w���е� 2DEG �ϵ����F����������ܶȺ�����w���ʣ��m���ڴ�����ʹ��ʵđ��á������ŘO�Y���Ͳ����Լ��ŘO���s�������_ͨ�ֵ늉��IJ�ͬ���F�м��g�� GaN ���w����Ҫ�Ѓɴ���ıM�� GaN ���w�ܺ������� GaN ���w�ܡ�
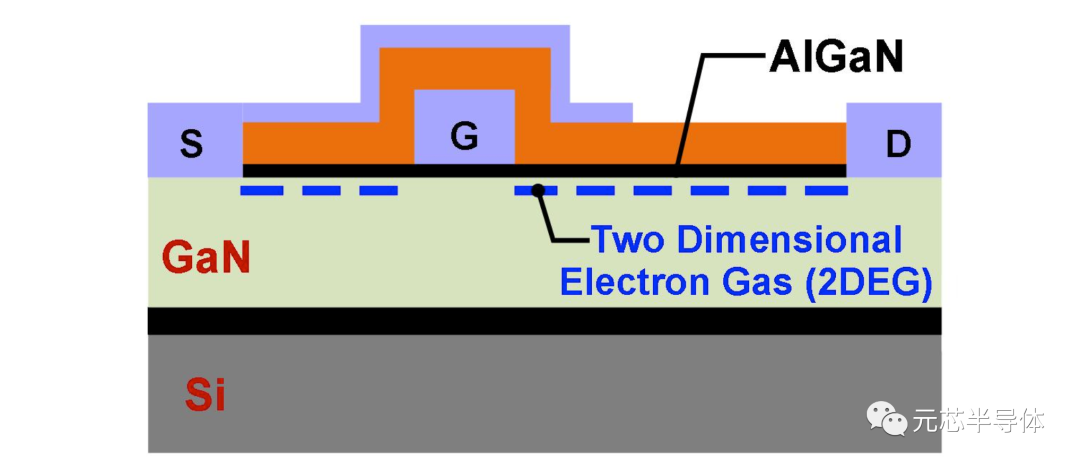
�D 1 GaN���w�ܵ������Y��
�ıM�� GaN ���w�ܵ������Y����D 2 ��ʾ���������_�P������B�£���D 2(a) ��ʾ������ GaN ���w�Ĺ������ԺͺıM�͖ŘO���ϣ��ŘOƫ��늉�����r���ıM��GaN���w��̎����Ȼ��ͨ��B�����P�]�ıM�� GaN ������Ҫ�ږŘO (G) ��Դ�O (S) ֮�gʩ��ؓƫ��늉�VGS���� VGS ���� GaN ���w�ܵ��_���ֵ VTH, D (VGS<VTH, D) �r����늜ϵ����Д࣬���w���P�]����D 2.2(b) ��ʾ���ڴ����g��©Դ늉���VDS�����ԾS�ַdz��ߵē���늉���Ȼ�������ںıM�� GaN ���w�ܣ���Ҫؓ�ŘO��늉�VGS���P�]���w�ܣ��@ʹ�� GaN �ŘO���·���OӋ׃�ø��ӏ��s��
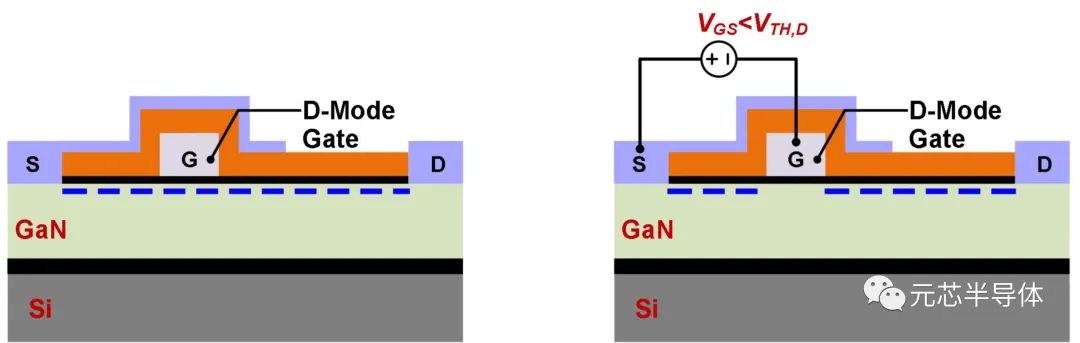
�D 2 �ıM�� GaN ���w�� (a) ���_��B��(b) �P���B
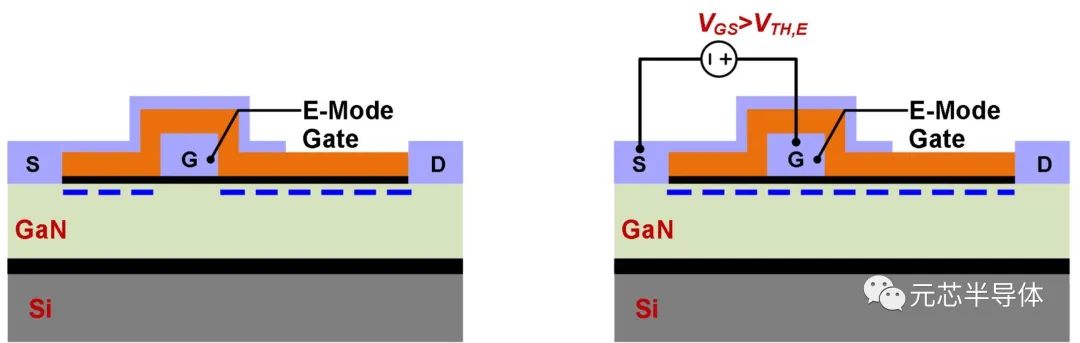
�D 3 ������ GaN ���w�ܣ�(a) ���P��B��(b) ��ͨ��B
���˾����ӵĆ��}���ƌW�Ұl���������� GaN ���w�ܣ�������Ҫؓ�ŘO늉����P�]���w�ܶ�ֻ��Ҫ��늉�����˺����˖ŘO���·���OӋ���D 3 �@ʾ�������� GaN ���w�ܵ������Y������D 3(a) ��ʾ���ږŘOƫ��늉�����r��GaN���w�܌�늜ϵ������P���B�������ǺıM�� GaN ���w�ܵij��_��B���������_ͨ GaN ���w�ܣ���Ҫʩ�����ĖŘOƫ��늉� VGS������������� AlGaN �� GaN ��߅�����γɸ��w���ʌ�늜ϵ����Ķ����F��һ�������_���ֵ늉�������ֵ�s��1.7V������ VGS �����_���ֵ늉� (VGS>VTH, E) �r�������� GaN ���w���_ͨ����D 3(b) ��ʾ�����⣬���˷�ֹ GaN ���w�ܰl���Ɖ��ԖŘO������ʩ�ӵ����ŘO늉���Ҫ�M���Qλ��Ԫо�댧�w�ṩ�˪��еČ����Qλ�ͱ��o���g���O��������������ϵ�y�Ŀɿ��Ժͷ����ԡ�
GaN������������
�����U�������� GaN ���w�ܵĹ���ԭ�����D 4 չʾ�˂�ݔ������������ VGS �_���ӽ� 1.7V ���w���_ʼ��ͨ������ GaN ���Ͼ��и���Ӹ��w���ʣ�GaN ���w�ܱ��F���߿猧����ʹ�����������������磬�� 3V �� VGS �£����͵� GaN ���w�ܿ��Ԃ��� 5A ������ IDS�����⣬GaN���ʾ��w�ܵ������S�ض����ӳʬFؓ�ض�ϵ�����@���Ա��o���������ڸߜش��ʹ�����r�����������ԓp�ġ�

�D 4 ������GaN���w�ܵĂ�ݔ����
���˱��^ GaN ���w���c�辧�w�ܵĖŘO��ݣ��xȡ�ˎ�����������������ĖŘO늺� QG �����M�б��^����� 1����ʾ���c���y�Ĺ�������ȣ�GaN �������Ќ�����늉�������w���ʡ���100V �͉�����ͬ�Č�ͨ��� RDS(ON) ��r�£�GaN ���w�ܵĖŘO늺ɱȹ�����С�� 12 �����@ʹ��GaN�����ɞ���l��Ч���_�P�Դϵ�y��������_�P����������
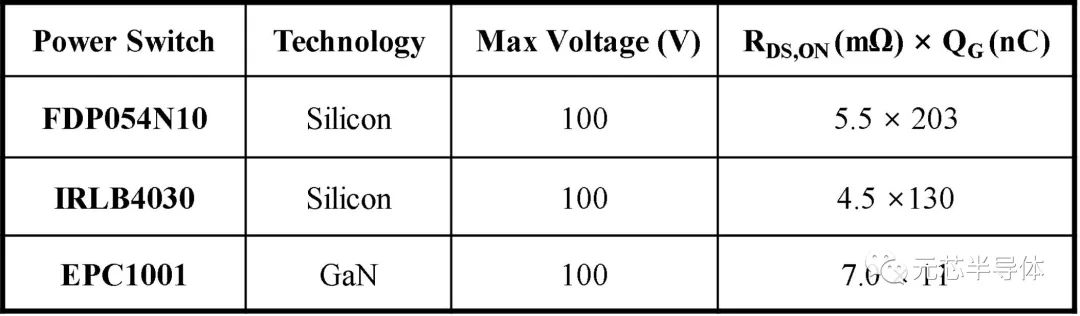
�� 1 ��� GaN ����֮�g�ŘO늺� QG �ı��^
�D 5 չʾ�˲�ͬ�ŘO��늉� VGS �µČ�ͨ���RDS(ON)���� VGS �ӽ����ŘO늉��r��RDS(ON)��ͣ������ϵ����иߌ���ԡ���ˣ����˽���GaN������ͨ�p�ģ���Ҫ�ڲ��p�ĖŘO�Y������r��������GaN ���w�ܵĖŘO��늉�����GaN���w�ܲ��Ĵ����ϵ�y�����У�����GaN���w��RDS(ON)�߂����ض�ϵ�����@ʹ��������c�辧�w�����Ƶ����ԣ����ڲ��ԔUչ���ʷ�����
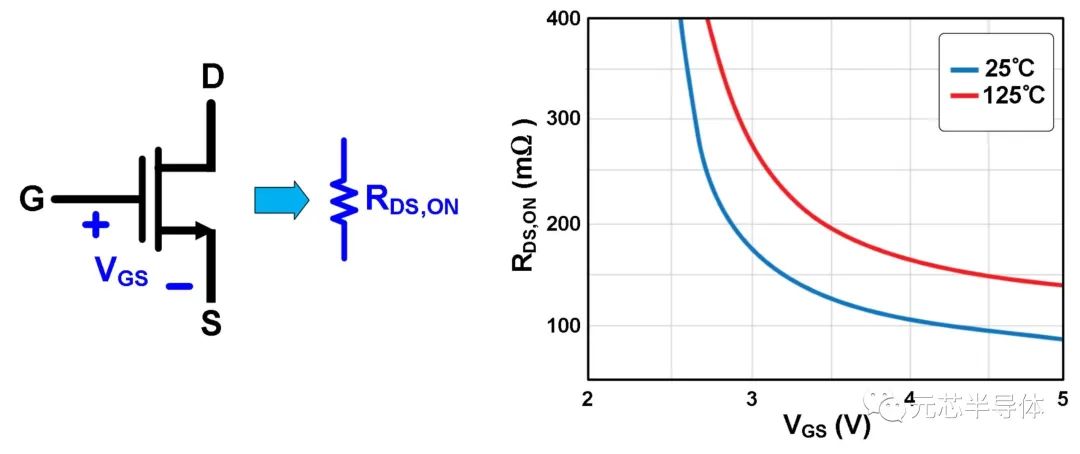
�D5. ��ͬ��VGS�ŘO늉��µČ�ͨ���

�D 6. ������ GaN ���w�ܵķ����������
�D 6 ��ʾ��GaN�ږŘO����늉�����r�£��ϵ��е������ȫ�ıM���@��ʹ GaN ���w��̎���P�]��B��Ȼ�����S��©�O늉��Mһ�����ͣ��ŘO��©�O֮�g���a����ƫ���������ŘO�·�������γɌ�늜ϵ������� GaN ���w�ܵ�©�O��Դ�O�Y�������Q������ͨ�ʬF����ֵ�����磬���Ҫ������� 4A �������©�O늉�׃�� -3V��VSD=3V�������⣬���ڛ]���ٔ��d���Ӆ��c��ͨ�� GaN ���w�ܛ]�з���֏͓p�ģ��@�@���������_�P�p�ģ�ʹ��dz��m�ϸ��l�_�P���á� |

