�S������ʽAI���w�ٰl(f��)չ�����ܣ�AI�����R���Ŀƻ�����F(xi��n)��(sh��)���ɞ��˂������еĵ������֡���(j��)�S����ϢWellsenn XR��(sh��)��(j��)��(b��o)��[1]��2024��ȫ��AI���R�N����152�f�_(t��i)��2025�ꌢ������350�f�_(t��i)��ͬ�����L(zh��ng)130%��
���@�����d�^�ı���һ��(ch��ng)���g(sh��)����(zh��n)�������ݡ�CMOS�D���������CIS����AI���R֮�ۣ����o��Խ��Խ���������g����CIS����ڡ�С���c����(qi��ng)�����g���ġ����������1cm2�ĪMխ�R���(n��i)������40�˵������t�������ݼ{����(qi��ng)���Ӱ���������@�����ИI(y��)���ֱ��ļ��g(sh��)���}��
��Ƅ�(chu��ng)�µ�������CIS���b���g(sh��)����TCOM��Tiny Chip On Module�����b�����Ǟ�˶�����

AI���R�Y(ji��)��(g��u)���ʾ��
С�ͻ���TCOM���b���g(sh��)��ͻ��
TCOM�ǻ��ڸ�Ƹ�����COM���b���g(sh��)����(j��)������������g���Б�(y��ng)���аl(f��)��COM���b���g(sh��)�������߶�COB��Chip On Board�����b���߂����(y��u)���Ĺ�W(xu��)ϵ�y(t��ng)���ܺͱ����ɿ��Եȡ����L(zh��ng)�ڵ����a(ch��n)��(sh��)�`�У��ܵ��͑��߶��J(r��n)�ɣ�Ŀǰ��Ӌ(j��)��؛�������^5�|�w��
�ڴ˻��A(ch��)�ϣ�TCOM����(j��)�Y(ji��)��(g��u)�c��ˇ���������g��(n��i)��(g��u)��������Ӱ��ģ�M�����ͬҎ(gu��)��COB���bоƬ��ģ�M�ߴ�sС10%�����ң��c�ИI(y��)�F(xi��n)�е�С�ͻ�������ȣ��߂��@���ijɱ���(y��u)��(sh��)�����ı����ɿ�����
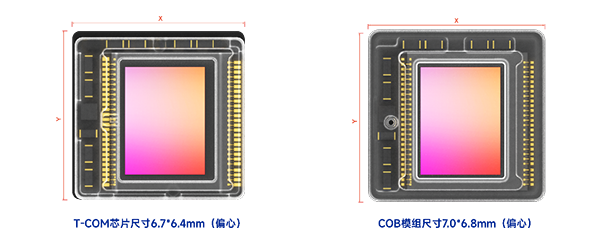
GC13B0 TCOM&COBоƬ�ߴ猦(du��)��
���������(sh��)�F(xi��n)�@һͻ�����O(sh��)Ӌ(j��)���أ�
�F(xi��n)�е�С�ͻ�CIS���b���������R���ɱ��c�����ɿ��Ե��p���y�}��ԓ��������COB�Y(ji��)��(g��u)����������Moldingģ�ߺ��O(sh��)�䣬��Ԫ������оƬ����·����Tģ�ܷ⡣�mȻ�ɿsСģ�M�ߴ磬�ҽY(ji��)��(g��u)��(qi��ng)�ȸߣ������S֮���������^�ߵijɱ���ͬ�r(sh��)����CISֱ���N�b���·�壬��(du��)���������У�SFR���D������������ܵ�Ӱ푡�
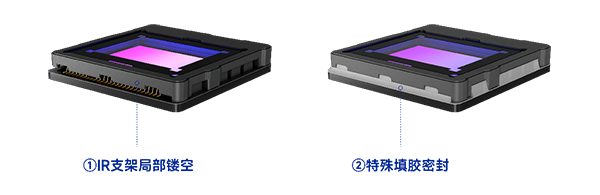
COB���F(xi��n)��С�ͻ�������TCOM��(du��)��
��TCOM�ڌ�(sh��)�F(xi��n)С�ͻ��O(sh��)Ӌ(j��)��ͬ�r(sh��)����������ܺͳɱ��ϵă�(y��u)��(sh��)�����ȣ�����֧���O(sh��)Ӌ(j��)�����B��CIS�cFPC�·��Ľɂ�(c��)��IR֧�ֲܾ��U�գ����ȿs�̼s10%��Ȼ����ê�(d��)�ص����z��ˇ���O(sh��)�䣬��Ԫ�������Ãɂ�(c��)��IR֧���cԪ����֮�g����һ���Ƕ�������z�ܷ⡣

TCOM��ˇ���Eʾ��
ͨ�^������(d��)���O(sh��)Ӌ(j��)��TCOMģ�M�ȿs�����L(zh��ng)�����ֲ������Y(ji��)��(g��u)��(qi��ng)�ȣ����m��AI���R���R���R�^���ľo���O(sh��)Ӌ(j��)�����O(sh��)���A(y��)��������g��������Ԫ��������ȫ���o��������ɞ���ܡ�
��AI���R���֙C(j��)����չ���������
TCOM���g(sh��)�đ�(y��ng)�È�(ch��ng)���h(yu��n)��ֹAI���R�������֙C(j��)��ƽ����X�ȽK�˺��ױؠ�(zh��ng)��TCOM���b���g(sh��)�������µĿ��ܡ�
���֙C(j��)������TCOM���M(j��n)һ���sСǰ�Ôz���^ģ�M��ʹǰ�zλ�ø��`�������N����Ļ߅���O(sh��)Ӌ(j��)���������ѵ�ȫ����Ч������(du��)�ں�z��TCOM�ɸ���ģ�M�߶ȣ��p�����C(j��)ģ�M��ʹ�֙C(j��)���w�����M(j��n)һ���������C(j��)��(j��ng)��(zh��ng)����
���gԽ�o����ɢ��Խ�P(gu��n)�I��ᘌ�(du��)�@һ�y�}������аl(f��)���˾���ɢ�პ(y��u)��(sh��)��COM������
��(d��ng)�֙C(j��)���m(x��)�Ĕz�߷ֱ��ʡ��ߎ���Ӱ��r(sh��)���������װl(f��)�C����ɢ��ѣ�����(hu��)Ӱ��O(sh��)�䷀(w��n)���ԺͰ�ȫ�ԡ��y(t��ng)Ӌ(j��)�Y(ji��)������[2]���֙C(j��)��(n��i)����������Ĝض�ÿ����10�棬��ɿ��Ծ͕�(hu��)����50%��ֵ��ע����ǣ����������l(f��)�������ʧЧ�������У��ߜ����l(f��)�Ĺ���ռ�ȸ��_(d��)55%��
COMɢ�᷽���ڂ��y(t��ng)DA�zɢ������ϣ������˸�Ч����(d��o)������z���M(j��n)һ������(qi��ng)ɢ��Ч������(sh��)�y(c��)��(sh��)��(j��)�@ʾ������50MP 1.0��m CISģ�M��4K 60fpsģʽ�£�COM���b����(du��)COB�܉ͼs5��C��ģ�M�ض����ஔ(d��ng)��ʹ���֙C(j��)�r(sh��)������һ��(g��)ɢ���L(f��ng)�ȣ�

COMɢ�᷽���Y(ji��)��(g��u)ʾ���c������ɢ��Ч����(du��)��
��AI���R�������֙C(j��)�ȽK���У�ÿһ�˵�����?j��)?y��u)����ÿ����(j��)�Ŀ��gጷš�ÿ����1�ȣ������Ñ��w�(y��n)���S�������COMϵ�з��b���������¶��x��CIS���b����(bi��o)��(zh��n)���ͻ���ɢ�ᡢ�����ܡ��߿ɿ��Ԍ�(sh��)�F(xi��n)������
���S���õČ�������(d��ng)�҂������Ǹ����o�д��ڡ� ���������R�������IJ��H��̓��(sh��)�ںϵ����磬���Ǽ��g(sh��)�c�Ñ��w�(y��n)�����δ������������ܣ�Ҳ����pӯ��
Ŀǰ�����500�f����CIS����AI���R�(xi��ng)Ŀ���a(ch��n)��δ������ƌ����m(x��)��CIS����ģ�����COMϵ�еȸ�����CIS���b���������O(sh��)���b�ϸ��p���������ܵ� ���۾����� |

